TSV介绍

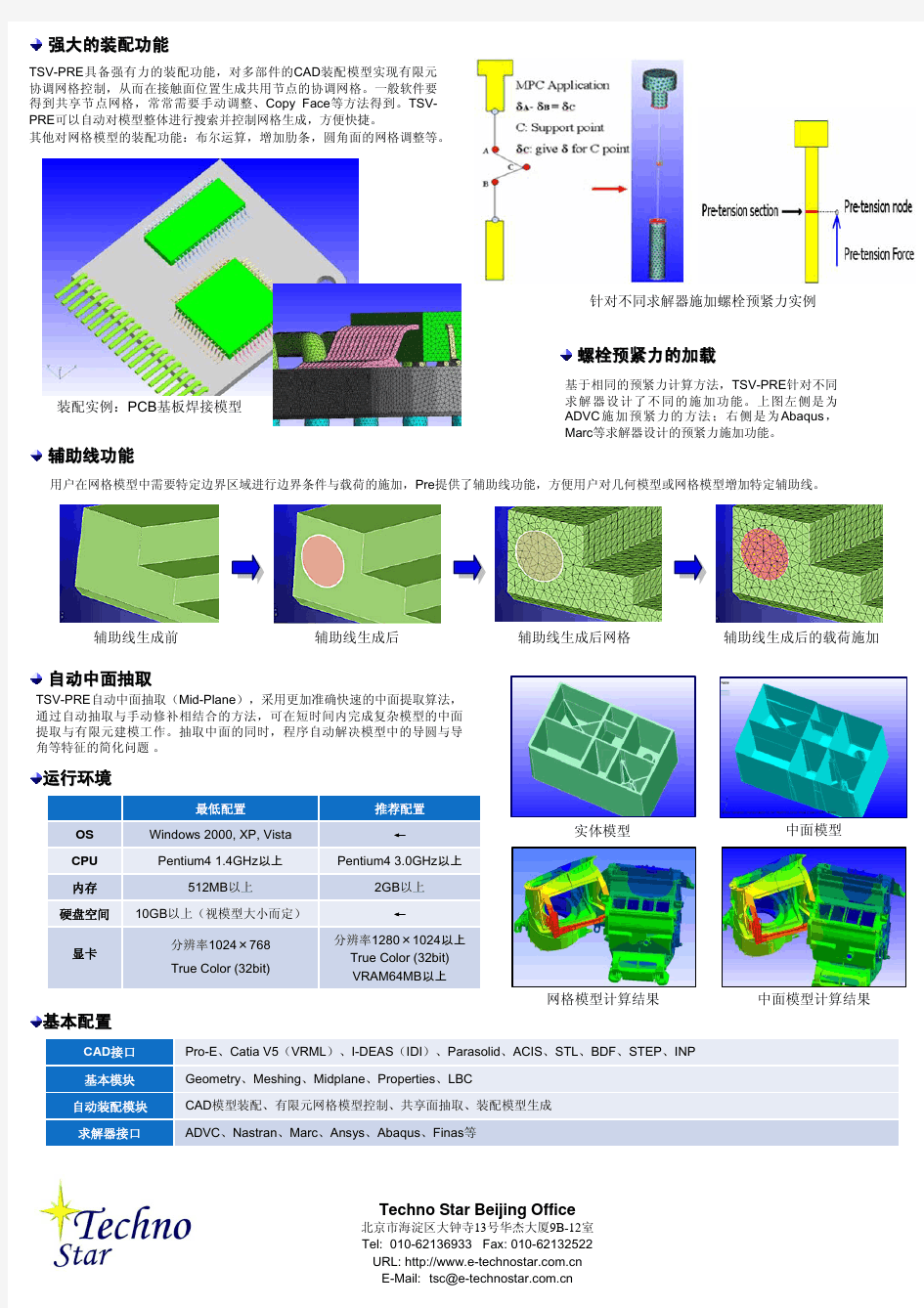
3D IC-TSV技术与可靠性研究
3D IC-TSV技术与可靠性研究 摘要:对三维(3 Dimension,3D)堆叠集成电路的硅通孔(Through Silicon Via,TSV)互连技术进行了详细的介绍,阐述了TSV的关键技术与工艺,比如对准、键合、晶圆减薄、通孔刻蚀、铜大马士革工艺等。着重对TSV可靠性分析的重要性、研究现状和热应力分析方面进行了介绍。以传热分析为例,实现简单TSV模型的热仿真分析和理论计算。最后介绍了TSV技术市场化动态和未来展望。 关键词: 3D-TSV;通孔;晶圆减薄;键合;热可靠性 0 引言 随着半导体制作工艺尺寸缩小到深亚微米量级,摩尔定律受到越来越多的挑战。首先,互连线(尤其是全局互连线)延迟已经远超过门延迟,,这标志着半导体产业已经从“晶体管时代”进入到“互连线时代”。为此,国际半导体技术路线图组织(ITRS)在 2005 年的技术路线图中提出了“后摩尔定律”的概念。“后摩尔定律”将发展转向综合创新,而不是耗费巨资追求技术节点的推进。尤其是基于TSV(Through Silicon Via)互连的三维集成技术,引发了集成电路发展的根本性改变。三维集成电路(Three-Dimensional Integrated Circuit,3D IC)可以将微机电系统(MEMS)、射频模块(RF module)、内存(Memory)及处理器(Processor)等模块集成在一个系统内[1],,大大提高了系统的集成度,减小了功耗,提高了性能,因此被业界公认为延续摩尔定律最有效的途径之一,成为近年来研究的热点。 目前3D集成技术主要有如下三种:焊线连接(Wire-Bonding)、单片集成(Monolithic Integration)和TSV技术[2]。焊线连接是一种直接而经济的集成技术,但仅限于不需要太多层间互连的低功率、低频的集成电路。单片集成是在同一个衬底上制作多层器件的新技术,它的应用受到工艺温度要求很高和晶体管质量较差等约束。基于TSV的3D集成可以实现短且密的层间互连,有效缩短了互连线长度,大大提高了系统集成度,降低了互连延时,提高了系统性能,缩小了封装尺寸,高频特性出色,芯片功耗降低(可将硅锗芯片的功耗降低大约40%),热膨胀可靠性高,同时还实现了异构集成,成为业界公认使摩尔定律持续有效的有力保证,所以备受研究者的青睐。 1 TSV技术与相关工艺 1.1 TSV技术介绍 TSV技术将在先进的三维集成电路(3D IC)设计中提供多层芯片之间的互连功能[3]。图2给出了最早的TSV结构示意图,这是1958年诺贝尔奖得主WilliamShockley提出的[4]。它是通过在芯片和芯片之间、晶圆和晶圆之间制作垂直导通,一般用导体材料钨、铝、铜、多晶硅或碳纳米管构成的互连线垂直穿过硅衬底以实现上下层芯片的信号互连[5],需要穿透组成叠层电路的各种材料以及很厚的硅衬底。TSV作为目前芯片互连的最新技术,使芯片在三维方向堆叠密度最大、芯片间的互连线最短、外形尺寸最小,大大改善芯片速度,产生低功耗性能。 使用硅基板和TSV的三维堆叠的结构。在 3D 芯片堆叠结构中,为了充分利用三维集成电路的优势[6],硅通孔能缩短堆叠芯片之间的垂直互连,硅中介层是在相同衬底上途经任何组件的硅衬底。TSV对通孔进行金属化处理,然后在孔上形成低熔点的凸点,使之成为导电通孔,再利用孔内的金属焊点以及金属层进行垂直方向的互连[7]。与目前应用于多层互连的通孔不同,TSV技术尺寸的一般要求如表1 所示。
三维封装铜柱应力及结构优化分析
第38卷第3期2017年3月 焊 接 学 报 TRANSACTIONSOFTHECHINAWELDINGINSTITUTION Vol.38 No.3March 2017 收稿日期:2015-03-18 基金项目:黑龙江省自然科学基金资助项目(E201449) 三维封装铜柱应力及结构优化分析 江 伟, 王丽凤 (哈尔滨理工大学材料科学与工程学院,哈尔滨 150080) 摘 要:文中利用有限元模拟软件ANSYS对三维立体封装芯片发热过程中整体应力及局部铜柱的应力情况进行了分析,并对三维封装的结构进行了优化设计.结果表明,最大应力分布在铜柱层,铜柱的应力最大点出现在铜柱外侧拐角与底部接触位置.以铜柱处最大应力作为响应,进行了结构参数优化,采用三因素三水平正交试验方法,分别使用铜柱直径、铜柱高度、铜柱间距三个影响因素作为变化的结构参数.结果表明,铜柱直径的变化对等效应力影响最大,铜柱间距次之,铜柱高度影响最小.且发现随着铜柱高度、铜柱间距、铜柱直径的不断增大其铜柱外侧拐角与底部接触位置的最大等效应力不断减小.关键词:有限元模拟;铜柱应力;正交试验;参数优化 中图分类号:TG404 文献标识码:A 文章编号:0253-360X(2017)03-0112-05 0 序 言 随着电子工业的不断发展,对微系统的功能、密度和性能要求不断提高,为顺应摩尔定律的增长趋势,芯片技术越来越向着小型化和高性能方向发展,并且越来越需要三维集成方案,在此推动下,穿透硅通孔技术(throughsiliconvias,TSV)应运而生 [1] ,成 为三维集成、芯片级和晶圆级封装的关键技术之一.TSV技术是通过在芯片与芯片之间、晶圆与晶圆之间作垂直互连,是实现芯片之间互连的最新技术.三维封装与传统封装相比有特殊的优势,TSV能够使三维方向堆叠密度最大,因此使得电性能大大提高,互连长度大大减小 [2] .3D堆叠芯片极薄,可以 小到50~100μm,非常容易产生裂纹[3] ,例如在热 循环和高压键合下极易产生裂纹,很多研究指出,通过调整铜柱高度,铜柱间距及铜柱直径可以避免裂纹的产生 [4,5] . 由于三维封装结构的复杂性和尺寸的微化,使得TSV技术变得更加复杂,许多有关TSV技术的研究也只是在初期,因此使用ANSYS软件利用有限元分析方法对三维堆叠封装进行模拟研究显得尤为重要.在小规模三维堆叠封装中,芯片产热是极大的,特别是芯片极薄的情况下会产生很大的温差,中间温度极高,对芯片造成损害,另外随着芯片封装尺寸 的减小和芯片的垂直堆叠,大量不同热膨胀系数的材料将围绕TSV,由于铜热膨胀系数相对较大,造成材料间热膨胀系数差很大,这样在热的作用下将产生大量的热应力,因此由于芯片发热问题而引起的热应力不得不被引起高度重视. Chukwudi等人 [6] 对3D-SIC封装中铜通孔Cu- Cu键合压力进行了研究,认为铜(16.7ppm/℃)与硅之间(2.3ppm/℃)热膨胀系数的不匹配,铜的自 由膨胀被大块的硅所限制将会在硅片内部产生应力而影响结构的整体性能,最终导致硅片的失效.文中虽然指出失效机制,但并未对此进行深入研究.因此研究铜与硅之间的结构力学性能具有重要的意义.Hsieh等人 [7] 对四层芯片堆叠封装体的热力学 性能进行了模拟计算研究.为了获得在堆叠IC封装的热应力分布,设计了4层堆叠IC封装(芯片对芯片)与TSV技术的结构.指出在芯片发热过程中,TSV受热应力的影响,封装体最大应力出现在芯片界面和TSV结构连接处.文中指出了最大应力的分布位置,但并未对影响应力分布的结构参数进行研究,因此研究铜结构参数对应力分布的影响具有重要意义.文中首先通过一组合适的参数研究了在芯片发热过程中三维封装结构整体应力情况及局部TSV通孔中铜柱的应力情况,然后把铜柱直径、高度和间距作为优化参数,通过使用正交试验方法对不同参数下铜柱最大应力数据进行分析,从而找到铜柱直径、铜柱高度和铜柱间距三者对铜柱应力影响的大小. 万方数据
三维集成封装的电热特性研究及优化设计
三维集成封装的电热特性研究及优化设计在技术发展、社会需要以及经济增长的驱动下,“延续摩尔”和“超越摩尔”成为了目前集成电路发展的两大趋势,在这种情况下,三维集成封装技术受到了广泛的认可。目前,三维集成封装技术在多方面都取得了突破性的进展,然而仍然存在由于内部复杂电磁环境导致的电可靠性问题,以及由于堆叠芯片增大了功率密度导致的热可靠性问题,针对这些问题,本文着重于三维集成封装的电热特性以及优化设计方面的创新研究,并取得了如下成果:1)研究了三维集成封装多端口互连的电特性与优化设计。我们首先提出了新型共面波导串扰屏蔽结构,分析其电特性并据此进行了优化设计,然后对结果进行了实验验证;接下来针对基于“地缺陷结构”的共模噪声滤波器,分析了各尺寸参数对于其电特性的影响并提出了应用机器学习进行优化的方法。2)显著的提高了应用去嵌入方法测量三维集成封装多端口硅通孔(TSV)高频电特性的测量精度。 我们首先分析了传统去嵌入测量结构与算法,得到将其应用于多端口高频电特性测量的两个补充条件,并通过修正测量结构与加入屏蔽TSV满足了这两个条件,进而提高了测量精度,其中插入损耗的最大相对误差从33.52%降低至4.67%,最后通过实验进行了验证。3)使用解析法研究了三维集封装TSV的横向热特性,包括TSV作为热源的稳态热特性以及TSV作为导热材料的瞬态热特性,并分别通过数值仿真对推导结果进行了验证。4)提出了基于流体制冷和机器学习的三维集成封装动态热管理方案。我们首先讨论了集成流体热槽的三维集成封装的建模仿真方法,然后提出了基于机器学习的优化控制方法并讨论了算法的计算复杂度,最后通过仿真模拟热管理系统工作,验证了该动态热管理方案的有效性。
集成电路TSV三维封装可靠性试验方法-编制说明
国家标准《集成电路硅通孔(TSV)三维封装可靠性试验方法》(征求意见稿)编制说明 1工作简况 1.1任务来源 本项目是2018年国家标准委下达的军民通用化工程标准项目中的一项,本国家标准的制定任务已列入2018年国家标准制修订项目,项目名称为《集成电路硅通孔(TSV)三维封装可靠性试验方法》,项目编号为:20182284-T-339。本标准由中国电子技术标准化研究院负责组织制定,标准归口单位为全国半导体器件标准化技术委员会集成电路分技术委员会(TC78/SC2)。 1.2起草单位简介 中国电子技术标准化研究院是工业和信息化部直属事业单位,专业从事工业和电子信息技术领域标准化科研工作。中国电子技术标准化研究院紧紧围绕部中心工作,立足标准化工作核心,研究工业和电子信息技术领域标准化发展战略,提出相关规划和政策建议;组织建立和完善电子信息、软件服务等领域技术标准体系,开展共性、基础性标准的研究制定和应用推广;承担电子产品的试验检测、质量控制和技术评价、质量监督检查和质量争议鉴定等工作;负责电子工业最高计量标准的建立、维护和量值传递工作;开展管理体系认证、产品认证、评估服务等相关活动;建立和维护标准信息资源,开展标准信息服务、技术咨询评估和培训活动。 1.3主要工作过程 接到编制任务,项目牵头单位中国电子技术标准化研究院成立了标准编制组,中科院微电子研究所、华进半导体封装先导技术研发中心有限公司、中国电子科技集团公司第十三研究所等相关单位参与标准编制工作。编制组落实了各单位职责,并制定编制计划。 编制组查找了国际、国内三维集成电路封装相关标准,认真研究了现行集成电路标准体系和相关标准技术内容,在此基础上形成了标准草案。 2标准编制原则和确定主要内容的论据及解决的主要问题 2.1本标准制定原则 本标准遵循“科学性、实用性、统一性、规范性”的原则进行编制,依据GB/T 1.1-2009规则起草,确立了本标准的范围、规范性引用文件、术语和定义。 2.2标准的主要内容与依据 2.2.1本标准的定位 本标准是三维(3D)集成电路(IC)封装系列标准中的一项,规定了采用硅通孔(TSV)
新型封装
(一) 硅通孔(TSV,Through -Silicon-Via)技术 3D 封装的发展趋势已经被清楚地确认,穿透硅通孔(TSV)的晶圆封装技术已不断地向 高量产发展。然而,许多问题的研究仍然在进行中,比如:对于通孔联结需要怎样的深宽比及哪些填充材料和技术能够满足它们。 穿透硅通孔(TSV) 将在先进的三维集成电路(3D IC)设计中提供多层芯片之间的互连功能。TSV 与目前应用于多层互连的通孔有所不同,一方面是尺寸的差异(直径1~100 μm,深度10~400 μm),另一方面,它们不仅需要穿透组成叠层电路的各种材料,还需要穿透很厚的硅衬底。目前制造商们正在考虑的多种三维集成方案,也需要多种尺寸的TSV 与之配合。 等离子刻蚀技术已经广泛应用于存储器和MEMS 生产的深硅刻蚀工艺,同样也非常适合于 制造TSV。 TSV 作为新一代封装技术,是通过在芯片和芯片之间,晶圆和晶圆之间制造垂直导通,实现芯片之间互连的最新技术,能够在三维方向使得堆叠密度最大,芯片之间的互连线最短、且外形尺寸最小,大大改善了芯片速度和低功耗性能。 (定义)硅通孔技术(TSV)是通过在芯片和芯片之间、晶圆和晶圆之间制作垂直导通,实现芯片之间互连的新技术(见图4 所示)。 TSV 技术被看做是一个必然的互连解决方案,是目前倒装芯片和引线键合型叠层芯片 解决方案的很好补充。许多封装专家认为TSV 是互连技术的下一阶段。实际上,TSV 可以很好取代引线键合。 硅通孔技术(TSV)是通过在芯片和芯片之间、晶圆和晶圆之间制作垂直导通,实现芯片 之间互连的最新技术。它将集成电路垂直堆叠,在更小的面积上大幅提升芯片性能并增加芯片功能。与以往的IC 封装键合和使用凸点的叠加技术不同,TSV 能够使芯片在三维方向堆叠的密度最大,外形尺寸最小,并且大大改善芯片速度和低功耗的性能。因此,业内人士将TSV 称为继引线键合(Wire Bonding)、TAB 和倒装芯片(FC)之后的第四代封装技术。 由于TSV 工艺的内连接长度可能是最短的,因此可以减小信号传输过程中的寄生损失 和缩短时间延迟。TSV 的发展将受到很多便携式消费类电子产品的有力推动,这些产品需 要更长的电池寿命和更小的波形系数。芯片堆叠是各种不同类型的电路互相混合的最佳手段,例如将存储器直接堆叠在逻辑器件上方。 TSV的优势:
TSV三维封装内部典型缺陷的特征识别方法研究
TSV三维封装内部典型缺陷的特征识别方法研究随着微电子技术的飞速发展,为了应对现代微电子器件高集成,小型化和高可靠性的封装要求,TSV(硅通孔,Through-Silicon Via,简称TSV)三维封装技术凭借其集成度高,低时延和低功耗等优良特点而受到广泛关注。与此同时,由于小孔径、高密度及高深宽比正逐渐成为TSV三维封装的主流发展趋势,极易造成其缺陷的频繁发生,而缺陷大多集中于晶圆和芯片内部,如果能掌握其缺陷的外在表现特征并加以识别,进而可以达到TSV三维封装内部缺陷检测的目的。本文主要以TSV内部缺陷响应机理研究为基础,采用理论分析,有限元仿真和试验结果验证相结合的方式,得到其缺陷下温度和应力的分布规律,识别和定位出相应的缺陷,通过掌握TSV内部缺陷的外在表现形式,从而可解决三维封装中内部缺陷难检测的问题。 具体工作内容如下:首先,综合阐述了目前关于TSV缺陷检测的常见方法,结合TSV三维封装基本结构和工作方式,着重分析了TSV三维封装内部的热传导过程,建立了TSV三维封装内部热传导微分方程和热阻网络模型,并在此基础上做了应力应变分析,为后续的仿真和试验提供理论支撑。然后,针对填充缺失、含有缝隙和底部空洞三种典型的TSV内部缺陷,分别建立了有限元模型,并进行了热-电和热-结构耦合条件下的有限元分析。两种耦合场下的仿真结果表明:从整体上来看所有含缺陷的TSV均显示出了与正常结构明显不同的温度和应力分布。 相比而言,在三种缺陷中,含有填充缺失的TSV显示出最明显的温度和应力分布及路径变化差异;其次为底部有空洞的TSV;而具有缝隙的TSV差异最小,并且还探究了TSV层指定路径上温度分布变化的规律。最后,设计并制备出了所需的TSV试验样品,并对样品进行了测量和试验系统的搭建。试验结果表明:(1)温
TSV硅通孔技术的研究解析
西安电子科技大学 硕士研究生课程考试试卷 科目集成电路封装与测试 题目硅通孔(TSV)工艺技术 学号 1511122657 班级 111504 姓名马会会 任课教师包军林 分 数 评卷人 签名 注意事项 1.考试舞弊者做勒令退学或开除学籍 2.用铅笔答题一律无效(作图除外) 3.试题随试卷一起交回 硅通孔TSV工艺技术
1511122657 马会会 摘要:本文主要介绍近几年封装技术的快速发展及发展趋势。简单介绍了TSV技术的发展前景及其优势。详细介绍了硅通孔工艺以及其关键技术。并针对TSV 中通孔的形成,综述了国内外研究进展,提出了干法刻蚀、湿法刻蚀、激光钻孔和光辅助电化学刻蚀法(PAECE)等四种TSV通孔的加工方法、并对各种方法进行了比较,提出了各种方法的适用范围。 关键词:后摩尔时代;封装技术;TSV;硅通孔 Abstract:This paper mainly introduces the rapid development and development trend of packaging technology in recent years.In the brief introduction of several vertical packaging technology, the paper focuses on the development of TSV technology and its advantages. The technology of Si - through hole and its key technologies are introduced in detail. In this paper, the research progress of TSV was summarized, and the method of dry etching, wet etching, laser drilling and photo assisted electrochemical etching (PAECE) was proposed, and four kinds of TSV through hole were compared. Keywords:Post Moore era; packaging technology; TSV; silicon through hole 引言 集成电路技术在过去的几十年里的到了迅速的发展。集成电路的速度和集成度得到了很大的提高并且一直遵循摩尔定律不断发展,即单位集成电路面积上可容纳的晶体管数目大约每隔18个月可以增加一倍。然而,当晶体管尺寸减小到几十纳米级后,想再通过减小晶体管尺寸来提升集成电路的性能已经变得非常困难,要想推动集成电路行业继续遵循摩尔定律发展就不得不寻求新的方法。 自从集成电路发明以来,芯片已无可辩驳地成为电子电路集成的最终形式。从那以后,集成度增加的速度就按照摩尔定律的预测稳步前进。摩尔定律的预测在未来若干年依然有效的观点目前仍然被普遍接受,然而,一个同样被广泛认同的观点是,物理定律将使摩尔定律最初描述的发展趋势停止。在这种情况下,电子电路技术和点路设计的概念将进入一个新的发展阶段,互连线将在重要性和价值方面得到提升。在被称作“超越摩尔定律”的新兴范式下,无论是物理上还是使用上,在z轴方向组装都变得越来越重要。目前在电子封装业中第三维正在被广泛关注,成为封装技术的主导。 图1 封装的技术演变与长期发展图
三维高密度组装技术的发展及新成果
课题:三维高密度组装技术的发展 及新成果 院(系) 专业: 学生姓名: 学号:
三维高密度组装技术的发展及新成果 XXX (桂林电子科技大学机电工程学院,广西桂林 541004) 摘要:三维高密度封装技术是一种可实现电子产品小尺寸、轻重量、低功耗、高性能和低成本的先进封装技术,该技术已广泛用于手机、数码相机、MP4及其他的便携式无线产品, 是微电子学领域的一项重大变革技术,对现代化的计算机、自动化、通讯业等领域将产生重大影响。随着人们对手持式电子设备不断提出的微型化、多功能化和集成化的需求,转化为采用三维(3D)方式装配印制电路板(PCB)强大推动力。为满足电子产品轻、薄、小以及系统集成的需求,各种新的封装结构正在不断推出. 三维封装(3D packages)愈来愈受到重视。本文概述了三维高密度组装思想在芯片封装领域的应用。 关键词:三维组装技术;3D-MCM;PIP;PoP;TSV;高密度封装;芯片堆叠 Three-dimensional high-density assembly technology development and new achievements XXX (School of Mechanical and Electrical Engineering of the Guilin University of Electronic Technology , Guilin, Guangxi 541004,China) Abstract: Three-dimensional high-density packaging technology is an enabling electronic products small size, light weight, low power consumption, high performance and low cost advanced packaging technology, which has been widely used in mobile phones, digital cameras, MP4 and other portable wireless products, is a major field of microelectronics revolution technology, the modern computer, automation, communications and other areas will have a significant impact. As people continue to raise handheld electronic device miniaturization, multi-functional and integration requirements, into a three-dimensional (3D) mode assembled printed circuit board (PCB) a strong force. Electronic products to meet the light, thin, small, and system integration requirements, a variety of new packaging structure is being constantly introduced. Dimensional package (3D packages) more and more attention. This article outlines the three-dimensional high-density chip package assembly of thought in the field of application. Key words: three-dimensional assembly technology, 3D-MCM, PIP, PoP, TSV;high-density packaging, chip stacking 1.三维高密度电子组装发展概述 在某种意义上,电子学近几十年的历史可以看作是逐渐小型化的历史,推动电子产品朝小型化过渡的主要动力是元器件和集成电路IC的微型化。所谓封装是指将半导体集成电路芯片可靠地安装到一定的外壳上,封装用的外壳不仅起着安放、固定、密封、保护芯片和增强电热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁,即芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。因此,封装对集成电路和整个电路系统都起着重要的作用。 随着手机、PDA 、数码相机、MP4等移动消费型电子产品对于功能集成、大存储空间、高可靠性及小型化等封装的要求程度越来越高,及宇航、卫星、计算机及通信等军事和民用领域对提高组装密度、减轻重量、减小体积、高性能和高可靠性等方面的迫切需求,加之3D-MCM在满足上述要求方面具有的独特优点,因此在MCM(多芯片组件)X 、Y平面内的二维封装的基础上,沿Z方向堆叠的更高密度的三维封装技术近年来得到了迅速发展。新的三维封装技术形式,或是将裸芯片,或是将封装体(如MCM)沿z 轴叠层
单片集成MEMS-IC圆片级真空封装方应用设计
单片集成MEMS-IC圆片级真空封装方应用设计 北京航天控制仪器研究所1、概述2、军事需求分析3、国内外研究概况、水平和发展趋势4、展望与思考 从国外领先惯性MEMS研究机构的研究成果可以发现,惯性MEMS器件模块顶层设计以及MEMS芯片的工艺设计、MEMS专用ASIC芯片设计、惯性MEMS芯片与MEMS专用IC芯片集成工艺设计等环节的协同对于惯性MEMS器件整体性能至关重要,惯性MEMS三维集成技术研究是惯性MEMS领域研究的一个重要环节,对于拉动惯性MEMS 器件研究水平、推动惯性MEMS应用发展具有重要意义。 惯性MEMS三维集成TSV互连技术通过提供垂直贯穿惯性MEMS芯片或MEMS专用集成电路IC芯片的TSV互连为两者层叠式立体化集成提供了便利,更重要的,为两者立体化集成和圆片级封装的一体化提供了设计空间,有效的降低了惯性MEMS三维集成模块的体积/重量、提高了集成度。 惯性MEMS三维集成TSV转接板技术通过为惯性MEMS芯片、MEMS专用IC芯片等提供公共衬底平台,具有提供与惯性MEMS芯片或MEMS专用IC芯片相匹配的线宽、低热膨胀系数失配的优点,可以有效降低惯性MEMS三维集成模块体积、重量、热应力水平等。更重要的,基于TSV转接板的惯性MEMS三维集成技术对惯性MEMS芯片、MEMS专用IC芯片工艺制程影响小,允许其他采用不同工艺制程的功能芯片集成TSV转接板衬底上,开放性好。在这一点上,符合未来惯性MEMS三维集成多功能融合趋势需求,将成为未来惯性MEMS三维集成TSV互连技术发展的重要方向。 近些年,国内清华大学、北京大学、东南大学、航天13所、航天33所、兵器科学研究院、中电13所、航空618所等高校科研院所对惯性MEMS器件开展了系统深入研究,取得了稳定的进步,建立了独具特色的惯性MEMS器件加工工艺,惯性MEMS器件部分指标达到或接近国际水平,目前处于应用突破阶段。而在惯性MEMS器件三维集成TSV互连技术方面的研究相对落后、与国外存在较大差距,亟需开展惯性MEMS三维集成技术方面的研究以加速惯性MEMS器件的应用与发展。北京大学对TSV互连与μBump、多层存
应用于三维封装中的硅通孔技术
- 18 - 收稿日期:2012-03-26 应用于三维封装中的硅通孔技术 邓小军1,曹正州2 (1.无锡创立达科技有限公司,江苏 无锡 214142;2.中国电子科技集团公司第58研究所,江苏 无锡 214035) 摘 要:随着集成电路日新月异的发展,当半导体器件工艺进展到纳米级别后,传统的二维领域封装已渐渐不能满足电路高性能、低功耗与高可靠性的要求。为解决这一问题,三维封装成为了未来封装发展的主流。文章简要介绍了三维封装的工艺流程,并重点介绍了硅通孔技术的现阶段在CSP 领域的应用,以及其未来的发展方向。关键词:三维封装;硅通孔;CSP 中图分类号:TN305.94 文献标识码:A 文章编号:1681-1070(2012)09-0018-06 The Through Silicon Via Technology Using in 3D Packaging DENG Xiao-jun 1, CAO Zheng-zhou 2 (1. Wuxi TreasureStar Technology Co ., LTD ., Wuxi 214142, China ; 2. China Electronics Technology Group Corporation No .58 Research Institute , Wuxi 214035, China ) Abstract: With the development of now day integrated circuit, the traditional 2D packaging can not satisfy the requirement of high function, low power and high reliability when the semiconductor device develops into nano level. To solve the problem, 3D packaging becomes the mainstream of future package. In this paper, authors introduce the process flow of 3D package and emphasize the through silicon via (TSV )technology using in CSP area and the further development’s direction. Key words: 3D packaging; TSV; CSP 1 引言 在过去的三十年间,半导体技术已经在二维领域得到了广泛的应用。一个关键原因就是金属氧化物半导体(MOS )器件数量的快速增长趋势是可以根据摩尔定律预测的[1] 。但是近年来实际的器件增长趋势已经和理想模型的预测有所差别了。因为随着芯片功能的增强,芯片内集成的晶体管数目越来越多,体积也越来越大,功耗也越来越高,kT /q 比无法继续在现有技术层面缩小,因此在不提高泄漏上限的基础上降低MOS 器件的阈值电压就变得十分困难。而阈值电压无法降低,降低功耗和提高器件 的性能这两种要求就会产生冲突。尤其是在高集成 度条件下,单个芯片内各个系统的互连引线过长和过多,其阻容延迟和寄生电容会使器件工作速度降低。另外,其所引发的信号传输延迟、信号带宽不足和控制时序的不一致性,会制约当前通信技术和大型计算机技术的发展。还有,互连引线过长引起的噪声问题也不容忽视,而各种噪声均与信号在互连引线中的传输距离密切相关。要满足上述性能要求,必须突破当前二维器件技术水平的制约。 大规模集成电路的结构是其中一种解决方案。随着电路集成度越来越高,信号的延迟主要取决于引线长度和引脚电容。三维大规模集成电路是一种能提升性能同时不需要增加功耗的解决途径。带来
三维集成电路
微处理器体系结构综述 题目三维集成电路综述 专业微电子学与固体电子学 学号1208090538 学生韩新辉 指导教师戴力 2013 年春季学期
三维集成电路综述 摘要:本文介绍了集成电路从开始发展到SOC再到NOC以及后来的三维集成电路中应用的3D NOC。然后从工艺(SOI技术和TSV技术)、拓扑结构、功耗等方面阐述了研究现状、需要亟待解决的技术问题以后发展方向。最后,对文章做了总结。 关键字:3D NOC 三维集成电路TSV 拓扑结构功耗 1 引言 从1947年第一个半导体晶体管的发明,到1958年采用硅平面工艺的集成电路诞生,直到后来的SOC,半导体集成电路一直遵循着摩尔定律高速发展着。随着集成电路技术的不断发展,在单一芯片上集成更多的资源已经成为片上系统(SOC)设计的重要挑战。在当前的高性能SOC设计中,已经可以包含多个处理器、存储器、模拟电路、数模混合电路等不同的IP单元。当SOC变得越来越复杂时,芯片的速度、功耗、面积、总线交换的效率等成为高性能SOC设计面临的最大问题。尤其是总线架构的系统结构大大的限制了SOC多个核之间高效的数据通信。其主要表现在三个方面:(1)扩展性差;(2)线通信效率低;(3)单一时钟同步问题。 1999年前后,一些研究机构开始使用系统的方法研究SOC通信单元,将计算机网络技术移植到芯片设计中来,提出了一种全新的集成电路体系结构NOC(Network On Chip),从体系结构上彻底解决总线架构带来的问题。NoC具有更高的带宽,它的网络拓扑结构提供了良好的可扩展性;由于NOC所使用的通信协议层本身属于独立的资源,因此提供了支持高效率可重用设计方法学的体系结构;NoC使用全局异步局部同步(Global Asynchronous Local Synchronous,GALS)机制,每一个资源节点都工作在自己的时钟域,而不同的资源节点之间则通过OCN进行异步通讯,很好地解决了总线结构的单一时钟同步问题。然而,二维片上网络结构随着核数的增加,通信性能并不能成比例的提升,因而限制了整个系统的性能。 三维集成电路制造技术可以通过将原二维集成电路中较长的水平互联线替
三维封装技术创新发展
三维封装技术创新发展(2020年版) 先进封测环节将扮演越来越重要的角色。如何把环环相扣的芯片技术链系统整合到一起,才是未来发展的重心。有了先进封装技术,与芯片设计和制造紧密配合,半导体世界将会开创一片新天地。 从半导体发展趋势和微电子产品系统层面来看,先进封测环节将扮演越来越重要的角色。如何把环环相扣的芯片技术链系统整合到一起,才是未来发展的重心。有了先进封装技术,与芯片设计和制造紧密配合,半导体世界将会开创一片新天地。现在需要让跑龙套三十年的封装技术走到舞台中央。
日前,厦门大学特聘教授、云天半导体创始人于大全博士在直播节目中指出,随着摩尔定律发展趋缓,通过先进封装技术来满足系统微型化、多功能化成为集成电路产业发展的新的引擎。在人工智能、自动驾驶、5G网络、物联网等新兴产业的加持下,使得三维(3D)集成先进封装的需求越来越强烈,发展迅猛。 一、先进封装发展背景 封装技术伴随集成电路发明应运而生,主要功能是完成电源分配、信号分配、散热和保护。伴随着芯片技术的发展,封装技术不断革新。封装互连密度不断提高,封装厚度不断减小,三维封装、系统封装手段不断演进。随着集成电路应用多元化,智能手机、物联网、汽车电子、高性能计算、5G、人工智能等新兴领域对先进封装提出更高要求,封装技术发展迅速,创新技术不断出现。 于大全博士在分享中也指出,之前由于集成电路技术按照摩尔定律飞速发展,封装技术跟随发展。高性能芯片需要高性能封装技术。进入2010年后,中道封装技术出现,例如晶圆级封装(WLP,Wafer Level Package)、硅通孔技术(TSV,Through Silicon Via)、2.5D Interposer、3DIC、Fan-Out 等技术的产业化,极大地提升了先进封装技术水平。 当前,随着摩尔定律趋缓,封装技术重要性凸显,成为电子产品小型化、多功能化、降低功耗,提高带宽的重要手段。先进封装向着系统集成、高速、高频、三维方向发展。
硅通孔_TSV_转接板微组装技术研究进展_刘晓阳
- 1 - 硅通孔(TSV )转接板微组装技术研究进展* 刘晓阳1,刘海燕2,于大全3,吴小龙1,陈文录1 (1. 江南计算技术研究所,江苏 无锡 214083; 2. 华进半导体封装先导技术研发中心有限公司,江苏 无锡 214135; 3. 中国科学院微电子研究所,北京 100029) 摘 要:以硅通孔(TSV )为核心的三维集成技术是半导体工业界近几年的研发热点,特别是2.5D TSV 转接板技术的出现,为实现低成本小尺寸芯片系统封装替代高成本系统芯片(SoC )提供了解决方案。转接板作为中介层,实现芯片和芯片、芯片与基板之间的三维互连,降低了系统芯片制作成本和功耗。在基于TSV 转接板的三维封装结构中,新型封装结构及封装材料的引入,大尺寸、高功率芯片和小尺寸、细节距微凸点的应用,都为转接板的微组装工艺及其可靠性带来了巨大挑战。综述了TSV 转接板微组装的研究现状,及在转接板翘曲、芯片与转接板的精确对准、微组装相关材料、工艺选择等方面面临的关键问题和研究进展。 关键词:硅通孔(TSV );转接板;微组装技术;基板;2.5D/3D 集成 中图分类号:TN305.94 文献标识码:A 文章编号:1681-1070(2015)08-0001-08 Development of Micropackage Technology for Through Silicon Via (TSV) Interposer LIU Xiaoyang 1, LIU Haiyan 2, YU Daquan 3, WU Xiaolong 1, CHEN Wenlu 1(1. Jiangnan Institute of Computing Technology , Wuxi 214083, China ;2. National Center for Advanced Packaging , Wuxi 214135, China ; 3. Institute of Microelectronics of Chinese Academy of Sciences , Beijing 100029, China ) Abstract: In recent years, 3D integration technology with the key technology of through silicon via (TSV) has been a research and development hotspot of semiconductor industry. Especially, 2.5D TSV interposer technology has been provided a solution for substituting low cost small size die system package for high cost system on chip (SOC). As the medilayer, interposer achieves 3D interconnection between die to die and die to substrate, and has reduced the cost of system on chip and power consumption. In the structure of 3D package based on TSV interposer, there have been very huge challenges for micropackage technology and reliability of interposer, with new type package structures and materials introduced, and with large size high power die and small size fine pitch microbumps applied. In the paper, the currently research of TSV interposer micropackage was summarized, including the key questions and development of warpage of interposer, pinpoint between die and interposer, materials of micropackage, and technics choice, etc. Key words: through Silicon via (TSV); interposer; micropackage; substrate; 2.5D/3D integration 收稿日期:2015-5-4 *基金项目:国家科技重大专项(2011ZX02709-2);国家自然科学基金(61176098) DOI:10.16257/https://www.sodocs.net/doc/6b15446157.html,ki.1681-1070.2015.0080
001 背景 三维集成封装中的TSV互连工艺研究进展_吴向东.caj
收稿日期:2012-06-28 三维集成封装中的TSV 互连工艺研究进展 吴向东 (中国电子科技集团公司第43研究所,合肥 230088) 摘 要:为顺应摩尔定律的增长趋势,芯片技术已来到超越“摩尔定律”的三维集成时代。电子系统进一步小型化和性能提高,越来越需要使用三维集成方案,在此需求推动下,穿透硅通孔(TSV )互连技术应运而生,成为三维集成和晶圆级封装的关键技术之一。TSV 集成与传统组装方式相比较,具有独特的优势,如减少互连长度、提高电性能并为异质集成提供了更宽的选择范围。三维集成技术可使诸如RF 器件、存储器、逻辑器件和MEMS 等难以兼容的多个系列元器件集成到一个系统里面。文章结合近两年的国外文献,总结了用于三维集成封装的TSV 的互连技术和工艺,探讨了其未来发展方向。关键词:互连;三维集成;硅通孔 中图分类号:TN305.94 文献标识码:A 文章编号:1681-1070(2012)09-0001-05 Research Status of Through-Silicon Via Interconnection for 3D Integration Technology WU Xiang-dong (China Electronics Technology Group Corporation No .43 Research Institute , Hefei 230088, China )Abstract: To meet the growing trend of Moore’s Law, chip technology has come “More than Moore” era of 3D integration. Further miniaturization of electronic systems and performance, 3D integration solution is needed more and more. As for the demand-driven, the through-silicon vias (TSV )interconnect technology emerged as the three-dimensional integration and it is one of key techniques for 3D integration and wafer-level packaging. TSV integration is compared with raditional assembly methods, there are several advantages to adopt this technology. The main ones are: reduction of interconnects length, electrical performance improvement induced and wider range of possibilities for heterogeneous integration. 3D integration would then allow to build systems including several families of components usually hardly compatible, like RF devices, memory, logic and MEMS. In this paper, nearly two years of foreign literature about 3D-TSV integrated interconnect technology and processes are summarized, the future trend of technology is discussed.Key words: interconnection; 3D integration; TSV 1 引言 半导体技术的飞速发展,来自对IC 性能要求不断提高的需求驱动,如功能增强、尺寸减小、耗电量与成本降低等。电子系统进一步小型化和性能提 高,越来越需要使用三维集成方案,硅通孔(TSV ) 是三维集成电路中堆叠芯片实现互连的一种新技术解决方案。它是一种系统级架构的新方法,内部含有多个平面器件层的叠层,并经由TSV 在垂直方向实现相互连接。如图1所示。采用这种方式可以大幅缩小芯片尺寸,提高芯片的晶体管密度,改善层间
相关文档
- 集成电路TSV三维封装可靠性试验方法-编制说明
- 应用于三维封装中的硅通孔技术
- 001 背景 三维集成封装中的TSV互连工艺研究进展_吴向东.caj
- 微系统封装技术第五讲三维系统级封装
- 三维集成电路
- 三维集成封装的电热特性研究及优化设计
- 单片集成MEMS-IC圆片级真空封装方应用设计
- TSV硅通孔技术的研究
- TSV三维封装内部典型缺陷的特征识别方法研究
- TSV硅通孔技术的研究分解
- 3D-IC TSV堆叠技术之发展趋势
- 三维封装铜柱应力及结构优化分析
- 三维高密度组装技术的发展及新成果
- 硅通孔_TSV_转接板微组装技术研究进展_刘晓阳
- 新型封装
- 集成电路TSV三维封装可靠性试验方法 编制说明
- 系统级封装中穿透性硅通孔建模及分析
- 3D IC-TSV技术与可靠性研究
- TSV硅通孔技术的研究解析
- 三维封装技术创新发展
最新文档
- 三亚旅游超强全攻略
- 三亚亚龙湾度假攻略
- 2023三下乡社会实践报告5000字(精选15篇)
- 大学生社会实践调研报告5000字6篇
- 社会实践心得与感悟5000字8篇
- 大学生毕业社会实践报告5000字
- 5000字寒假社会实践报告三篇
- 研究生社会实践报告5000字(9篇)
- 实习报告范文5000字【精选五篇】(精选)
- 关于社会实践调查报告5000字参考范文5篇
- 社会实践报告5000字(精选多篇)
- 毛概社会实践报告5000字
- 大学生毕业社会实践报告5000字
- 大学社会实践报告5000字
- 研究生社会实践报告5000字范文(五篇)
- 大学生寒假社会实践报告范本5000字
- 社会实践调查报告5000字三篇
- 暑假支教社会实践报告5000字
- 实习报告总结5000字(三篇)
- 成功人生十大要素!
